3。1 实验样片的制作 10
3。2 直径为 500μm 的焊球缺陷检测 10
3。3 焊球的特征提取 14
3。4 本章小结 15
4 基于神经网络的焊球缺陷分析 16
4。1 人工神经网络概述 16
4。2 基于 BP 神经网络的焊球缺陷分析 16
4。3 基于概率神经网络(PNN)的焊球缺陷分析 20
4。4 本章小结 22
5 全文总结 23
参考文献 24
致谢 26
1 绪论
1。1 研究背景
在当今这个信息化时代里,以半导体集成电路(Integrated Circuit,IC)为基础 的电子信息技术产业已成为我国经济的支柱产业[1]。半导体产业的三大支柱包括 半导体集成电路的设计、制造和封装测试。其中,封装测试业因为直接影响集成 电路的性能、成本和可靠性,所以相比于集成电路的设计和制造来说在近年来得 到了更多的重视和发展,在 IC 产业中扮演着越来越重要的角色 。一般来说,微 电子封装可以划分为四个层次[2],零级封装指的是芯片层次上的互联;一级封装 指的是单芯片或多芯片上的 I/O 接口与基板互联;二级封装指的是电路板级的封 装;三级封装指的是整机组装,将二级封装连入整机母板。要实现 IC 芯片与基 板之间的机械和电气连接则要通过互联技术将 IC 芯片的焊区与基板的焊区连接 起来。
传统的芯片互连技术主要分为引线键合(Wire Bonding, WB)、载带自动焊
(Tape Automated Bonding, TAB)和倒装焊(Flip Chip Bonding, FCB)[3]。引线 键合是使用细小的金属引线将芯片焊盘与基板连接起来,通过使用超声焊、热压 焊和超声热压焊的方法实现芯片和外界之间信号的输入和输出。尽管可能存在信 号传输延迟、引线脱落和不利于封装体积减小等问题,但是因其成本低、工艺简 单的特点,引线键合技术仍然是电子封装特别是低端封装所使用的主流技术。载 带自动焊是使用已经光刻出引线图案的载带将芯片固定在基底上。在这之前需要 在裸芯片上制作出触突,用来提高键合面的高度,并且防止键合时引线与邻近的 金属相短路[4]。然后使用热压键合或共晶键合的方法将载带上的引线与触突相键 合,这一过程称为内引线键合。在进行过电学测试和通电老化等过程之后,从载 带的相应位置上切下带引线的芯片,这就是外引线键合。这一方法不能有效地提 高封装密度。倒装焊是将芯片倒扣在基板上,使芯片的电气面朝向基板,然后通 过焊球将芯片的焊区与基板的焊区形成机械连接,从而实现信号的传输。其结构 如图 1-1 所示。
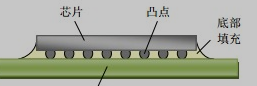
图 1-1 倒装芯片的结构示意图
因为倒装芯片的凸点不仅可以采用边缘分布也可以采用阵列式分布,所以可 以通过阵列分布的方法使得在单位面积内,I/O 接口数量有效增加,并且提高封 装密度。同时,芯片与基板通过直接键合,提高了信号传输的性能,也符合封装 技术小型化、轻薄化的发展趋势[5-6]。因此,倒装焊在封装技术中使用得也更加 的普遍。在倒装焊结构中,由于焊球处于芯片与基板的焊盘之间,实现了二者的 机械连接和电气连接,所以焊球在这一结构中显得至关重要。但是焊球在工作时 容易受到应力的影响并容易发生形变,所以焊球的失效继而导致电子封装的失效 还比较常见,材料之间的热膨胀系数差别较大加上倒装焊朝着凸点高密度和超细 间距的方向发展,焊球的缺陷问题也更加明显[7],容易发生焊球空穴、焊球裂纹、 焊球脱开和缺失等常见缺陷,如图 1-2 所示。因此,为了能够有效地提高电子封 装的可靠性,必须对高密度倒装焊的缺陷检测方法进行比较分析和研究。